
SolVisionกรณีศึกษา
การตรวจสอบการบัดกรีแบบ BGA ด้วย AI
กรณี
การตรวจสอบการบัดกรี BGA อย่างแม่นยำ
เทคโนโลยี Ball Grid Array (BGA) เป็นวิธีการบรรจุชิปเซมิคอนดักเตอร์ที่มีความหนาแน่นสูง ซึ่งช่วยลดโอกาสการลัดวงจรและเพิ่มความน่าเชื่อถือของระบบโดยใช้การจัดเรียงของลูกบอลบัดกรีขนาดเล็กที่ด้านล่างของแพคเกจเพื่อเชื่อมต่อกับแผงวงจร (PCB) อย่างหนาแน่นBGA แบบพลาสติกซึ่งมักใช้ซับสเตรตแบบลามิเนต เป็นทางเลือกที่คุ้มค่าสำหรับการผลิตจำนวนมาก โดยเฉพาะในอุตสาหกรรมอิเล็กทรอนิกส์สำหรับผู้บริโภคและแอปพลิเคชันที่ต้องการควบคุมต้นทุนอย่างไรก็ตาม ในระหว่างกระบวนการบัดกรีแบบรีโฟลว์ ความแปรปรวนของอุณหภูมิอาจทำให้ PCB และ BGA บิดตัว ส่งผลให้เกิดข้อบกพร่อง เช่น บัดกรีไม่ติด, ลูกบอลบัดกรีซ้อนกัน, จุดบัดกรีเย็น หรือช่องว่างในบัดกรี ซึ่งอาจทำให้เกิดลัดวงจรหรือการเชื่อมต่อที่ไม่มั่นคงการตรวจสอบที่แม่นยำจึงมีความสำคัญต่อความน่าเชื่อถือและการทำงานของผลิตภัณฑ์ขั้นสุดท้าย
ความท้าทาย
ความแม่นยำในการตรวจจับข้อบกพร่องของ BGA
วิธีตรวจสอบด้วยแสงแบบดั้งเดิมมักไม่สามารถตรวจสอบคุณภาพการบัดกรีของ BGA ได้อย่างมีประสิทธิภาพ โดยเฉพาะในบริเวณที่มีลูกบอลบัดกรีหนาแน่นใต้แพคเกจการถ่ายภาพด้วยรังสีเอกซ์ (X-ray) มีความสำคัญในการเจาะทะลุแพคเกจเพื่อระบุข้อบกพร่องที่ซ่อนอยู่ใต้พื้นผิวอย่างไรก็ตาม ภาพ X-ray มักมีสัญญาณรบกวนพื้นหลังสูงและคอนทราสต์ต่ำ ทำให้ระบบตรวจสอบแบบอิงกฎเกณฑ์ไม่สามารถตรวจจับข้อบกพร่องได้อย่างแม่นยำ
แนวทางแก้ไข
การตรวจจับข้อบกพร่องของการบัดกรี BGA ด้วย AI
SolVision ใช้เทคโนโลยี Deep Learning ในการฝึกโมเดล AI ด้วยภาพตัวอย่างที่มีการระบุข้อบกพร่อง เช่น การบัดกรีไม่ติด หรือการซ้อนกันของลูกบอลบัดกรีด้วยอัลกอริธึม AI ขั้นสูง SolVision ไม่เพียงตรวจจับข้อบกพร่องได้อย่างแม่นยำ แต่ยังเร่งความเร็วในการตรวจสอบ ทำให้การควบคุมคุณภาพเป็นไปได้รวดเร็วยิ่งขึ้นโมเดลได้รับการฝึกให้สามารถตรวจจับข้อบกพร่องที่ละเอียด แม้ในภาพ X-ray ที่มีสัญญาณรบกวนหรือคอนทราสต์ต่ำ ซึ่งระบบตรวจสอบแบบเดิมไม่สามารถทำได้ส่งผลให้สามารถตรวจจับข้อบกพร่องได้อย่างแม่นยำ เพิ่มความน่าเชื่อถือในการตรวจสอบ และลดการแจ้งเตือนผิดพลาด
การตรวจจับข้อบกพร่องในการบัดกรี BGA
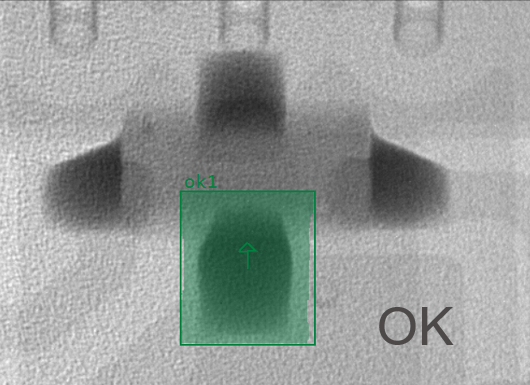
ปกติ
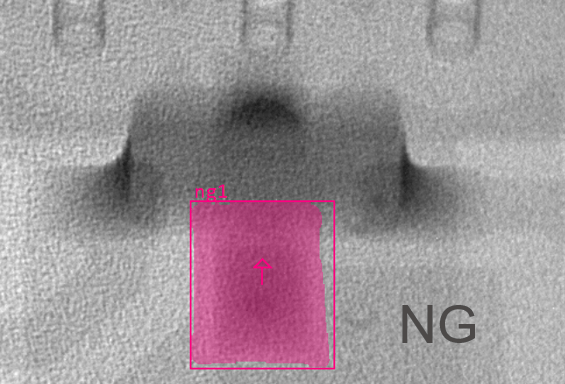
ไม่ผ่าน
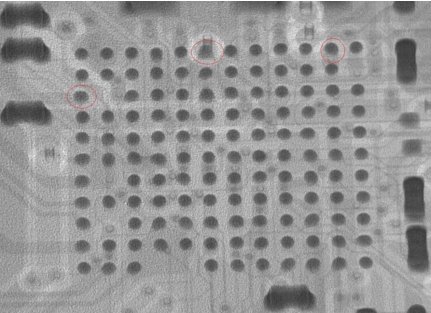
ขนาดไม่ถูกต้อง
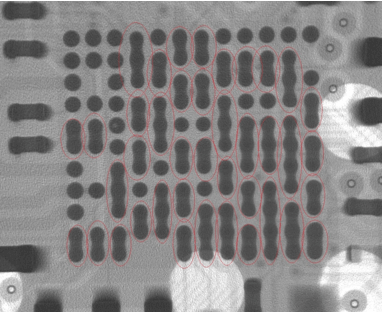
ลัดวงจร