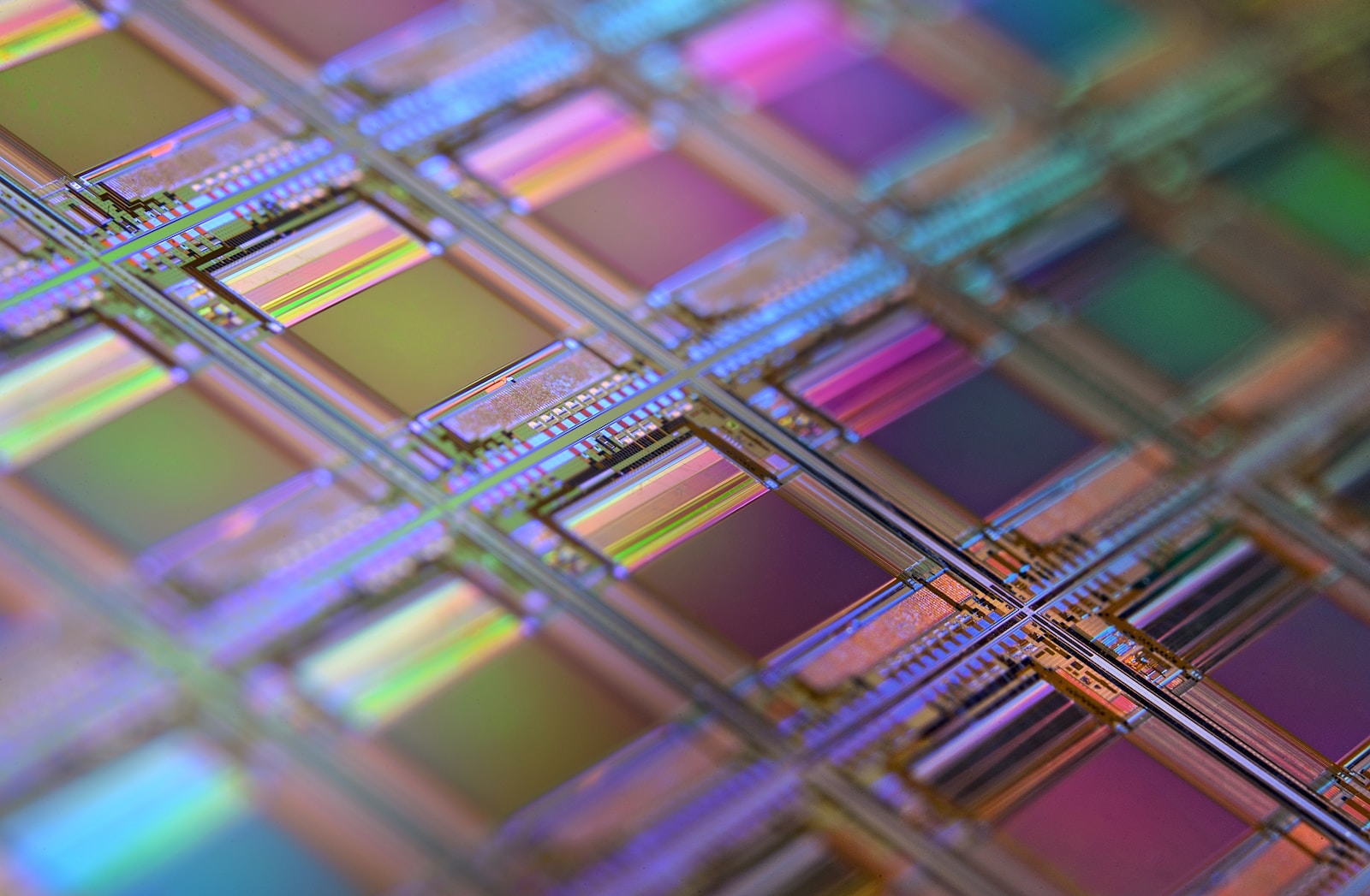
SolVisionÉtude de cas
Contrôle de qualité du découpage des wafers
Inspection par IA des défauts des lames de découpe
Qualité des lames et outils de découpe des wafers
Le développement rapide des produits électroniques modernes a intensifié la demande et les exigences de qualité pour les puces semi-conductrices. Les avancées technologiques dans la fabrication ont également conduit à des wafers en silicium plus légers, plus fins et plus petits. Pour assurer un rendement élevé et optimiser le débit de production, le découpage et la séparation des wafers sont des aspects cruciaux à surveiller, la clé de la qualité du découpage résidant dans la lame utilisée et son contrôle.
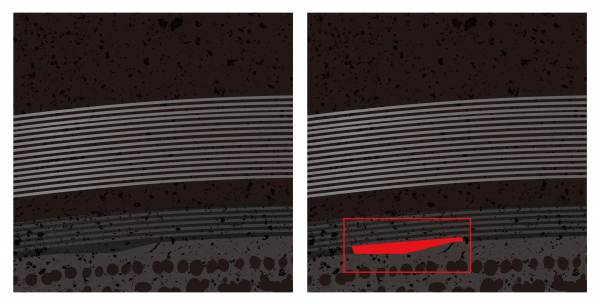
Motifs circulaires et arrière-plans complexes
Le découpage des wafers est un processus courant dans les industries des semi-conducteurs et de l’optoélectronique. Lorsque ce processus ne peut pas maintenir un rendement et une efficacité optimaux sans compromettre les caractéristiques des puces, la capacité de production est fortement impactée. Le contrôle qualité des lames de découpe repose principalement sur l’inspection des défauts d’apparence. Les lames endommagées présentent souvent des lignes irrégulières ou des défauts de perçage multiples sur leur surface. Les motifs denses et en anneaux des lames de découpe créent également des arrière-plans complexes qui réduisent les taux de détection des systèmes d’inspection traditionnels.
Inspections visuelles basées sur l’IA
Grâce à l’outil de segmentation de SolVision, les lignes irrégulières et les défauts de perçage multiples sont étiquetés dans des images d’échantillons pour entraîner le modèle d’IA. En exploitant des algorithmes puissants et une technologie avancée de vision industrielle, SolVision peut identifier divers défauts sur les lames de découpe des wafers en temps réel afin de garantir leur qualité, sans être affecté par la complexité des arrière-plans ou des défauts.
Inspection par IA
Image scannée

Résultat de détection
