
SolVisionÉtude de cas
Détection des défauts d’écaillage dans le découpage de wafers
Contrôle de qualité des dies de semi-conducteurs avec l’IA
Réduction de la taille des wafers de semi-conducteurs
Le sciage de wafers permet de séparer le wafer en dies individuels pour un traitement ultérieur. Alors que l’électronique moderne exige des wafers plus fins, plus petits et plus légers, la réduction des puces de wafer nécessite des processus de découpe plus minutieux. Les chemins de coupe sont réduits, les cristaux de silicium deviennent plus fragiles et les dommages causés par le sciage sont plus fréquents.
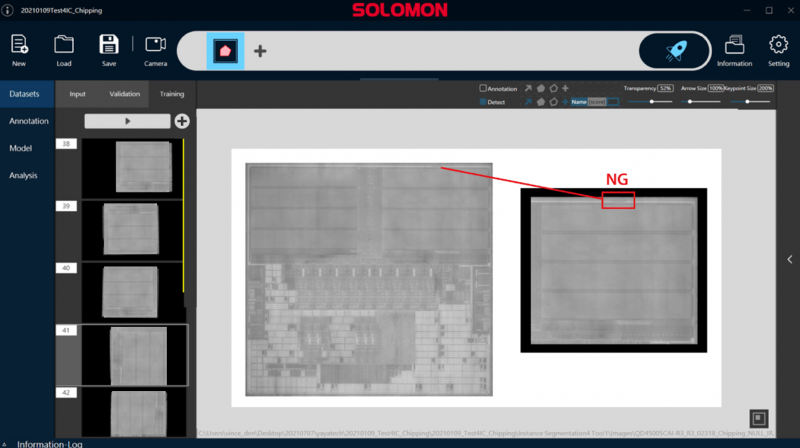
Imprévisibilité des fissures sur les bords des dies
Les bords fissurés causés lors du sciage des wafers endommagent la résistance du wafer. Dans les cas graves, cela peut entraîner une rupture lorsque la puce est soumise à une contrainte lors des processus de production ultérieurs. La localisation, la taille et la forme des fissures varient à chaque fois, et l’inspection optique traditionnelle ne peut pas identifier avec précision ces défauts imprévisibles.
Établir des bases pour l’emballage avec l’IA
Offrant une reconnaissance supérieure, SolVision peut entraîner un modèle d’IA capable d’inspecter les wafers et de reconnaître les défauts de production grâce au traitement d’image. Le système permet de détecter et de localiser automatiquement différentes variations de bords ébréchés en temps réel, réduisant considérablement la possibilité de rupture lors des processus d’emballage ultérieurs.
Inspection par IA
Bords fissurés