
SolVision사례 연구
웨이퍼 다이싱에서의 칩핑 결함 감지
AI를 활용한 반도체 다이 품질 관리
반도체 웨이퍼 크기 축소
웨이퍼 톱 절단(Wafer Sawing)은 웨이퍼를 개별 다이로 분리하여 후속 공정을 진행할 수 있도록 하는 과정입니다. 최신 전자 제품은 더 얇고, 작고, 가벼운 웨이퍼를 요구하기 때문에 웨이퍼 칩의 크기가 줄어들수록 더욱 정밀한 절단 공정이 필요합니다. 절단 경로가 좁아지고 실리콘 결정이 더 취약해지면서 톱 절단으로 인한 손상이 더 빈번하게 발생합니다.
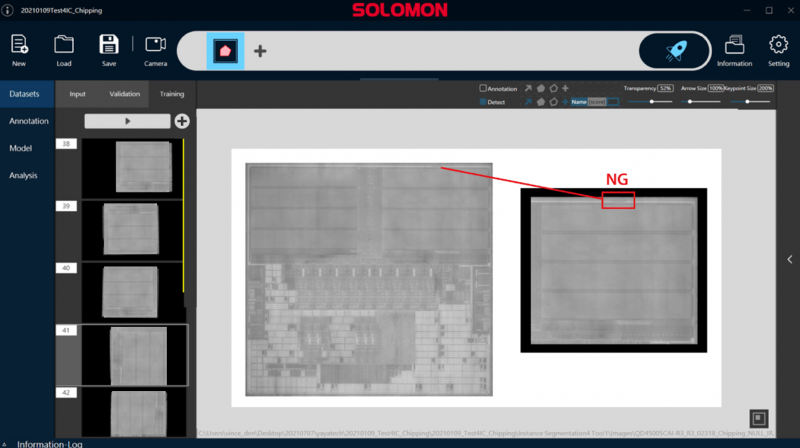
예측하기 어려운 다이 가장자리 균열
웨이퍼 다이싱 과정에서 발생하는 균열은 웨이퍼의 강도를 저하시킬 수 있습니다. 심한 경우, 후속 생산 공정에서 칩에 스트레스가 가해질 때 파손으로 이어질 수 있습니다. 균열의 위치, 크기 및 형태는 매번 다르게 나타나며, 기존의 광학 검사 방식으로는 이러한 예측 불가능한 결함을 정확히 감지하기 어렵습니다.
AI로 패키징 공정의 기반 마련
우수한 인식 능력을 갖춘 SolVision은 AI 모델을 학습시켜 이미지 처리를 통해 웨이퍼를 검사하고 생산 결함을 인식할 수 있도록 합니다. 시스템은 다양한 형태의 칩핑된 가장자리를 자동으로 감지하고 실시간으로 위치를 파악할 수 있어, 이후 패키징 공정에서 발생할 수 있는 파손 가능성을 크게 줄여줍니다.
AI 검사
균열 가장자리 감지