課題
効率的で信頼性の高いチップパッケージング
ボールグリッドアレイ(BGA)技術は、高度な半導体チップのパッケージング手法として好まれており、電気的短絡問題を解決するために開発されました。この方法は、チップの底面に小さなはんだボールを配置することで、パッケージング面積を減少させ、信頼性を向上させます。

メーカーは一般的にプラスチックBGAを使用し、コスト効果の高い解決策として積層基板を活用しています。しかし、リフローはんだ付け中の温度変動により、PCBやBGAが変形し、濡れ不良やはんだボールの重なりが生じ、短絡を引き起こすことがあります。
挑戦
はんだ付け継手のX線検査におけるノイズ削減とエッジの可視性向上
従来の光学検査方法では、底面に集中したはんだボールのはんだ付け品質を確認することはできません。潜在的な偽はんだ付けを検出するためには、X線装置が不可欠です。しかし、X線画像はしばしば背景ノイズが多く、グレースケールで明確なエッジがないため、ルールベースのシステムでの分析が困難です。
ソリューション
AIによるX線画像処理の向上
ディープラーニングを活用し、SolVisionはラベル付きサンプル画像を使用して、AIモデルに重なったはんだボールの偽はんだ付け欠陥の特徴を教えます。トレーニング後、AIモデルはノイズの多い背景や不明確なエッジのX線画像でも、さまざまなはんだ付け欠陥を正確に検出および認識する能力を示します。
欠陥検出
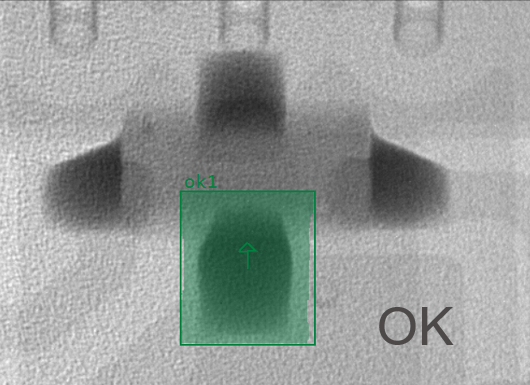
OK
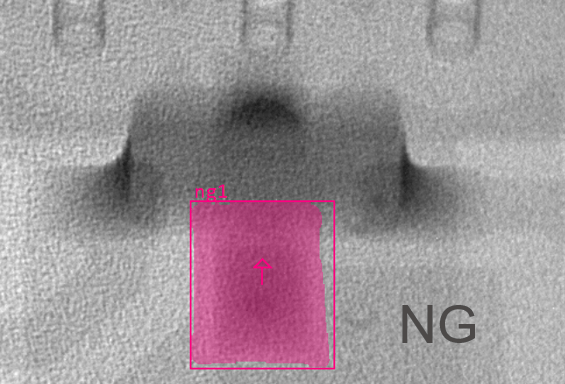
NG
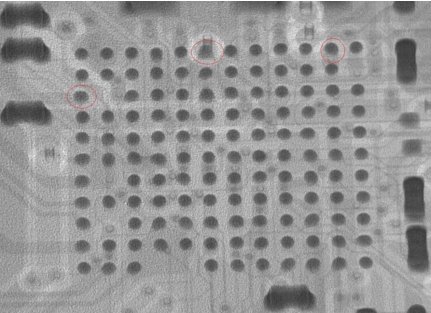
不適切なサイズ
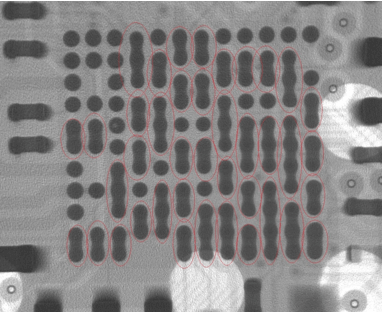
短絡
