
SolVision成功案例
晶粒边缘崩裂检测解决方案
以AI辅助半导体晶粒品质控管
半导体晶芯片尺寸微缩:
晶圆切割制程技术的考验
加工完成的晶圆需透过切割(sawing)制程将晶粒(die)切割分离以执行后续封装工序。随着现代电子产品的体积越趋轻薄短小,芯片尺寸亦不断微缩,相同晶圆尺寸內切割的晶粒数量越来越多,切割道也越来越窄,增加晶粒边缘崩裂的风险。因此,確保检出晶圆在切割制程(Wafer Die-Saw)中所造成的崩裂对于后续封装制程的良率控制至关重要。
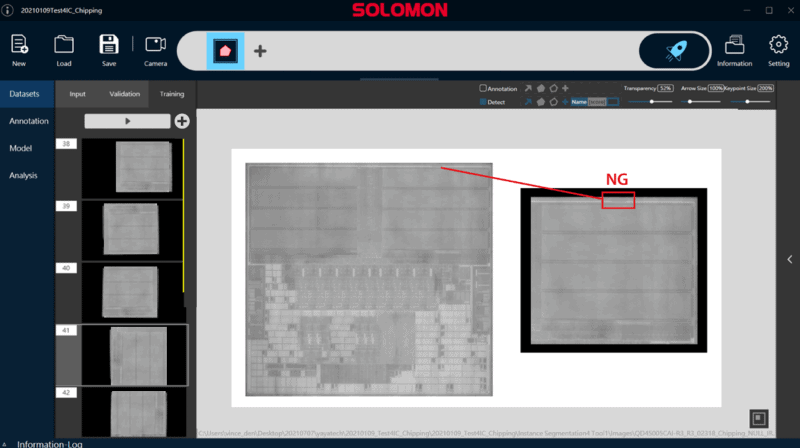
晶圆切割制程的复杂参数:晶粒边缘崩裂的不確定性
晶圆切割制程中可能造成晶粒边缘崩裂(Chipping)瑕疵,影响芯片强度甚大,严重时可能导致芯片在后段制程受到应力时发生芯片断裂情形。由于崩裂瑕疵出现的位置及型態不固定,以致传统光学检测 (AOI) 测无法精准地将瑕疵检出,影响整体产品良率。
为封装制程打好基础:透过AI掌握晶粒的崩裂瑕疵
运用 SolVision AI影像平台的实例切割技术,将影像样本中的瑕疵特征予以標註並借以训练AI模型,完成训练的AI模型即可自动检出并标注晶粒边缘崩裂瑕疵的位置,大幅降低芯片在后续封装制程中断裂的风险。
晶圆切割检测案例
边缘崩裂