
AIを活用したBGAはんだ接合検査
ケース説明
高精度BGAはんだ接合検査
ボールグリッドアレイ(Ball Grid Array:BGA)パッケージは、高密度半導体設計において広く採用されており、電気的信頼性の向上と短絡リスクの低減に寄与します。電気接続は、パッケージ底面に配列されたはんだボールによって形成され、BGAとPCB間に高密度かつコンパクトな相互接続を実現します。
量産工程では、積層基板を用いたプラスチックBGAが一般的です。リフロー工程においては、熱応力や温度変化の影響によりPCBやパッケージが変形し、ぬれ不良、はんだボールのブリッジ、コールドジョイント、ボイドなどの欠陥が発生する可能性があります。これらの欠陥は短絡や接続信頼性の低下を招くため、高精度なBGAはんだ接合検査が不可欠です。
課題
隠れたBGAはんだ接合部の検査難易度
従来の光学検査では、パッケージ下に隠れたBGAはんだ接合部を直接確認することができず、内部欠陥の検出にはX線検査が必要となります。しかし、X線画像はコントラストが低く、ノイズが多いという課題があります。
このような条件下では、従来のルールベース検査では十分な精度を確保できません。はんだボールの形状や密度のばらつきにより検査の安定性が低下し、誤判定が増加するため、量産ラインでの安定運用には限界があります。
BGAはんだ接合欠陥の分類
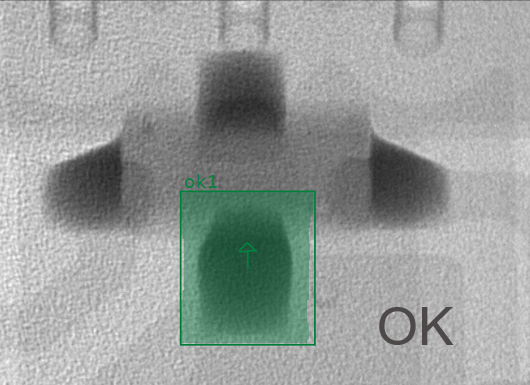
OK:良品はんだ接合
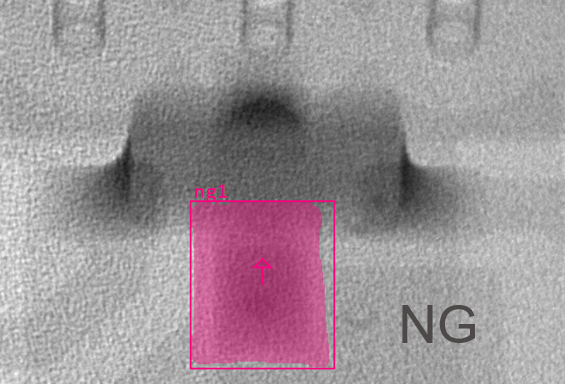
NG:不良はんだ接合
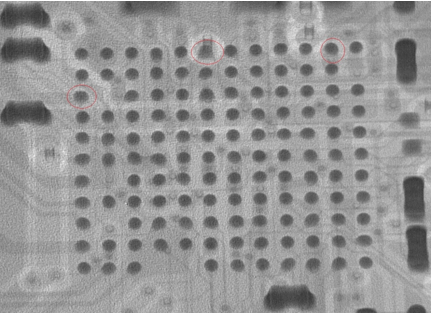
サイズ異常(Wrong Size):
はんだボール寸法の異常
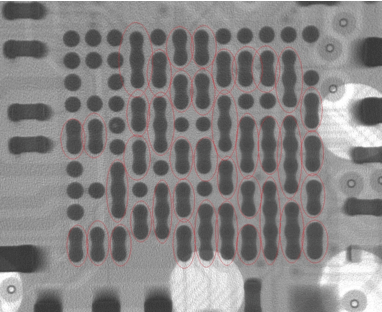
短絡(Short Circuit):
はんだ接合間の電気的短絡