
使用AI進行BGA 焊接檢測
案例說明
高精度 BGA 焊接檢測
球柵陣列(Ball Grid Array, BGA)封裝廣泛應用於高密度半導體設計中,可提升電氣可靠性並降低短路風險。其電氣連接是透過封裝底部排列的焊球陣列來實現,使 BGA 與 PCB 之間能進行高密度且緊湊的互連。
在大量生產中,常見的是採用層壓基板的塑膠 BGA。於回流焊接過程中,熱應力與溫度變化可能導致 PCB 或封裝變形,進而產生未潤濕、焊球重疊、冷焊點及空洞等缺陷。這些缺陷可能造成短路或降低連接可靠度,因此,精準的 BGA 焊接檢測至關重要。
挑戰
隱藏式 BGA 焊點的檢測困難
傳統光學檢測無法檢查位於封裝底部的 BGA 焊點,必須透過 X 光檢測才能發現內部缺陷。然而,X 光影像通常對比度低、背景雜訊高。
在此情況下,規則式檢測系統難以有效運作。焊球形狀與密度的變化會降低檢測穩定性並增加誤判率,使其在實際產線環境中的檢測效果受到限制。
BGA 焊接缺陷分類
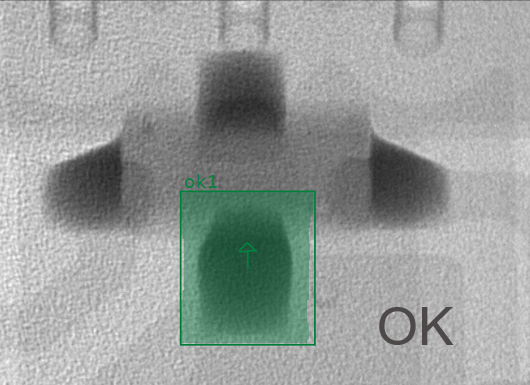
OK:合格的焊點
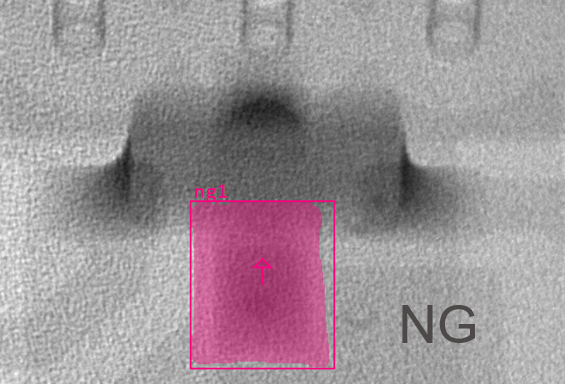
NG:不良焊點
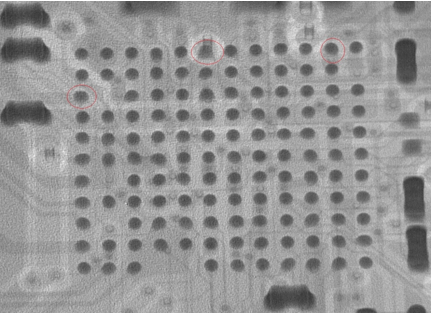
尺寸異常(Wrong Size):焊球尺寸異常
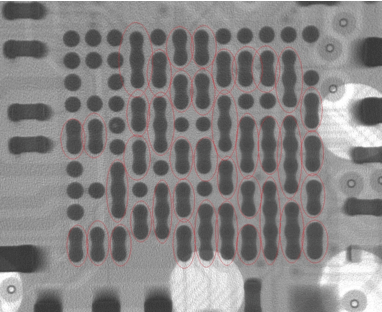
短路(Short Circuit):焊點之間產生電性短路